Cross section Polisher & FIB 특징 비교
페이지 정보
본문
현미경 시료를 준비할 때, 전처리 방법은 이미지의 선명함과 신뢰성에 직접적인 영향을 미칩니다. 거칠기, 오염, 표면 손상 등의 결함은 미세한 세부 형상을 가릴 수 있으며 데이터 불일치로 이어질 수 있습니다.
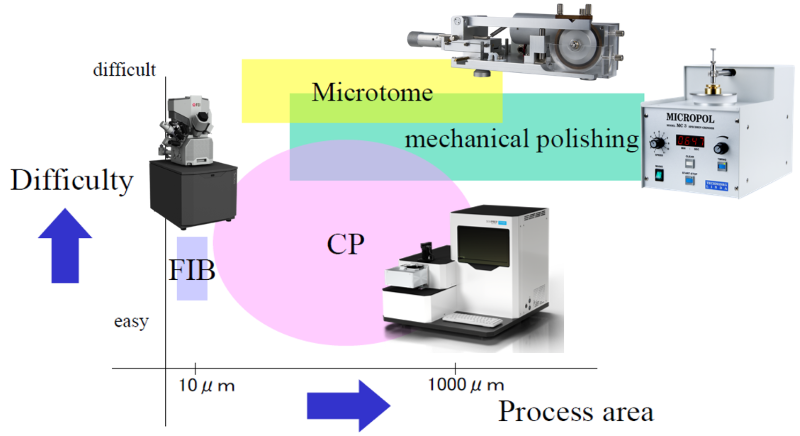
시료를 분석하기 위한 전처리 장비는 여러가지가 있습니다. 기본적으로 큰 시료를 절단하는 절단기(Microtome, Micro saw, Sawing machine), 단면을 매끄럽게 가공하는 연마기(Mechanical polishing, Ion beam polishing)등이 있습니다.
이온 빔 연마(Ion beam polishing)는 이온을 정밀하게 제어하여 시료 표면의 물질을 제거 및 가공하는 시료 전처리 방법입니다. 기존의 기계적 연마와 달리 이온빔 연마는 인공적 결함을 최소화하며, 고해상도 이미징에 필요한 결함 없는 미세 표면을 구현합니다.
분석 장비에 따른 이온밀링
주사전자현미경(SEM) - 단면 시료 제작. 시료의 구조, 층상, 결정 정보 확인.
투과전자현미경(TEM) - TEM 시료 준비.
이온 빔 연마의 종류
Ion beam polishing은 주로 Cross section Polisher(Ion miller, Ion Milling System, Broad Ion Beam)와 FIB(Focused Ion Beam, Dual beam SEM)이 있습니다.
두 장비 모두 가속된 이온을 사용하여 재료를 얇게 연마하지만, 빔 형상, 정밀도, 처리량, 최적화된 사용 분야에서 차이가 있습니다. 적절한 기술을 선택하기 위해서 각 장비의 장점, 한계와 사용 사례를 알아야 합니다.

그림2. Cross Section Polisher와 Focused Ion Beam 구조 비교

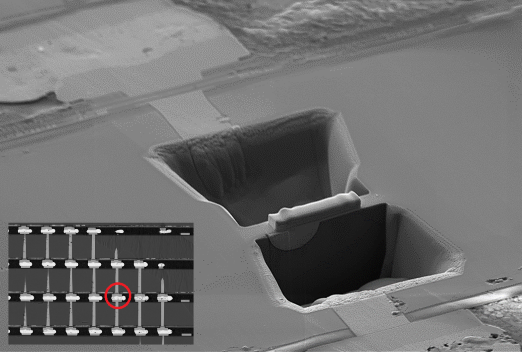
그림3. Cross Section Polisher(좌)와 FIB(우) 가공 면적 비교

Cross section Polisher 연마
Cross section Polisher는 일반적으로 아르곤 이온으로 구성된 광역 저에너지 이온 빔을 사용하여 시료 표면을 밀링합니다. 이를 통해 μm 단위의 매끄럽고 균일한 표면을 생성합니다. 이온 빔의 저에너지 특성으로 인해 시료 손상이 최소화됩니다.1
Cross section Polisher 연마의 장점
- 대면적 커버리지: mm 단위 영역에 걸쳐 평탄하고 균일한 표면을 생성하여 SEM 또는 EBSD 분석용 시료 준비에 매우 효과적입니다.
- TEM 박막화 이상적: 기계적 결함 없이 전자 투과 영역을 생성함으로써 미세구조 고해상도 이미징을 가능하게 합니다.
- 손상 없는 준비: 넓고 저에너지 이온 빔을 사용하므로 재료의 비정질화, 이식 및 재증착(Redeposition)을 최소화합니다. 밀링 과정에서 시료를 흔들며 커튼 현상(Curtain effect)을 방지하며, 이는 세라믹, 복합재, 폴리머 또는 생체재료와 같은 민감한 재료를 준비할 때 유용합니다.
- 공간 요구 사항: 일반적인 실험실 환경의 책상에 설치 가능합니다. 상대적으로 진동, 먼지, 전자기장 환경 조건이 낮습니다.
- 사용 편의성: 상대적으로 단순하여 실험실 내 다수의 사용자가 쉽게 조작자로 훈련될 수 있습니다.
CP 연마의 한계점
- 대형 시료 어려움: 대형 시료(cm ~ mm)에는 효율적이지 않아 기계적 연마에 비해 긴 시간이 소요됩니다.
- 제한된 정밀도: μm 단위의 정밀도를 구현할 수 있으나, nm 단위의 영역을 선택할 수 없습니다.
- 전문성: FIB보다는 쉽지만, 기존 기계식 연마 방법만큼 널리 보급되지는 않았습니다.

집속 이온 빔(FIB) 연마
집속 이온 빔 연마는 액체 갈륨으로 구성된 좁고 고에너지의 이온 빔을 활용하며, 나노미터 단위의 정밀도로 방향을 제어할 수 있습니다.2 최근에는 플라즈마를 이용한 에너지 빔을 사용하기도 합니다(Plasma FIB).
Cross section polisher와 달리 FIB 시스템은 사용자가 밀링 영역을 특정할 수 있어 나노 구조 가공 및 TEM 시편(TEM lamella) 준비에 필수적입니다.
FIB 연마의 장점
- 높은 정밀도: FIB 이온 빔은 높은 공간 분해능을 가져 nm 단위의 정확도로 입계, 내포물, 균열 또는 결함 영역을 지정할 수 있습니다.
- 좁은 면적에서 높은 스퍼터링 속도: FIB 시스템은 빠른 스퍼터링 속도를 가지며, 더 좁은 영역에서 시료를 빠르게 가공할 수 있습니다.
- 이중 빔 기능: FIB 시스템은 SEM과 결합되어 밀링 중 실시간 이미징이 가능합니다. 이를 통해 구조를 시각화하고 실시간으로 밀링 경로를 조정할 수 있습니다.
- 다용도성: 밀링 외에도 FIB는 회로 편집 및 가공에 활용될 수 있습니다. 또한 순차적 밀링과 이미징을 통해 미세구조에 대한 단층 촬영 및 3D 시각화가 가능합니다.
- 표적 시료 추출: FIB는 정확한 위치에서 TEM 라멜라를 준비할 수 있습니다. TEM을 사용하는 분석과 연구에 필수적입니다.
FIB 연마의 한계점
- 이온 손상 위험: 갈륨 이온이 표면에 주입되어 비정질화를 유발하거나 커튼 이펙트를 발생시킬 수 있습니다. FIB로 시료를 준비할 때는 추가적인 저에너지 마무리 단계가 종종 필요합니다.
- 대면적 처리 시 낮은 처리량: FIB는 mm 단위 표면 연마에는 비효율적입니다. nm 단위의 면적이 이상적인 대상입니다.
- 높은 비용과 복잡성: FIB는 숙련된 운영자가 필요하며 많은 유지관리 비용이 필요합니다.
장비 사용 목적
Cross section polisher와 FIB 연마는 상호 보완적인 기술입니다. 많은 연구실에서 전자 현미경 분석의 품질과 범위를 극대화하기 위해 이 두 기술을 병행하여 사용합니다. 두 장비를 모두 보유하면 유연성을 확보할 수 있습니다. Cross section polisher는 크고 매끄러운 표면 준비에 탁월한 반면, FIB는 타의 추종을 불허하는 특정 부위 정밀도를 제공합니다. 하지만 예산이 제한된 연구실의 경우 Cross section polisher와 FIB 중 하나를 선택해야 합니다.
Cross section polisher 연마는 상대적으로 쉽게 손상 없는 넓은 표면을 생성할 수 있다는 점에서 가치가 있습니다. 전자후방산란회절(EBSD) 분석을 위한 금속조직시료를 준비하는데 최적의 장비입니다. FIB도 유사한 결과를 얻을 수 있지만 더 많은 시간과 비용이 소요됩니다. 반면 Cross section polisher 연마는 기계적 연마 장비와 동일한 실험실에서 수행할 수 있으며 신속하게 고품질 결과를 제공합니다. 기타 Cross section polisher 응용 분야로는 TEM용 시료 박막화, 단면 제작 등이 있습니다.
FIB 연마는 주로 nm 수준의 정밀도로 알려져 있습니다. 이는 특히 TEM 라멜라 준비와 같이 특정 부위 밀링이 필요한 응용 분야에서 가치가 높습니다. FIB – TEM 분석 시스템으로 원자 단위의 결정구조, 계면, 결함 분석이 가능합니다.
결론
Cross section polisher와 FIB는 전자 현미경 시료 준비를 위한 상호 보완적 기술입니다.
Cross section polisher는 넓고 매끄러운 표면을 효율적으로 준비하는 데 탁월하여 일상적인 SEM 및 EBSD 작업에 이상적입니다.
FIB는 TEM 라멜라 준비 및 결함 분석과 같은 고정밀, 특정 부위 작업에 필수적입니다.
두 장비를 모두 보유하는 것이 가장 완벽한 해결책이지만, 예산이 제한된 실험실의 경우 각 기술의 특화된 장점과 한계를 고려하는 것이 최선입니다.
|
요소
|
Cross section Polisher (CP)
|
Focused Ion Beam (FIB)
|
|
이온 빔 형상 |
넓게 퍼짐 |
좁고 날카로움 |
|
가공 면적
|
mm ~ μm, 비교적 넓은 면적 |
μm ~ nm, 좁은 면적 특정 |
|
정밀도
|
낮음 |
높음 |
|
시료 대미지
|
적음 |
비교적 큼, Ga 오염, 커튼 효과 |
|
복잡성
|
중간 |
높음 __ |
|
사용 목적
|
단면 절단, 표면 연마-EBSD, TEM 시편 마무리 |
TEM lamella 준비, nano scale 가공, 3D 모델링 |
References
Hanke, L. D.; Schenk, K. H.; Scholz, D. R. Broad beam ion milling for microstructure characterization. Materials Performance and Characterization 2016, 5 (5), 767–779.
Sezen, M. Focused Ion beams (FIB) — novel methodologies and recent applications for multidisciplinary sciences. In InTech eBooks; 2016.
M. Sezen, ‘Focused Ion Beams (FIB) — Novel Methodologies and Recent Applications for Multidisciplinary Sciences’, Modern Electron Microscopy in Physical and Life Sciences. InTech, Feb. 18, 2016. doi: 10.5772/61634.
https://www.nanoscience.com/blogs/broad-ion-beam-vs-focused-ion-beam-polishing-choosing-the-right-technique-for-sample-preparation/